IMC观察与测量
2015-08-17 浏览量:8347
背景
近年来,随着电子工业无铅化的要求,研究以Sn为基体的无铅钎料与基板的界面反应日益增多,其中SnAgCu无铅焊料被国际上公认为最有可能替代SnPb焊料的合金系统。
在电子产品中,常常以铜为基板材料,焊接和服役过程中焊料与铜基板之间界面上反应是引起广泛关注的研究课题。由于SnAgCu无铅焊料中Sn的含量较高,焊接温度也比较高,导致了焊点中Cu的溶解速度和界面金属间化合物(intermetallic compound,IMC)的生长速度远高于SnPb系焊料焊点中的情况。相关研究表明,焊点与金属接点间的金属间化合物的形态和长大对焊点缺陷的萌生及发展、电子组装件的可靠性等有十分重要的影响。如何避免IMC的过多生长已成为研究者普遍关注的问题,而对IMC形貌及其生长规律的理解和表征是控制IMC生长的前提。
本文以Sn-Ag-Cu系无铅焊料与Cu基板间的交互作用为例,介绍IMC的形成、形貌与性质。
本文中仅讨论含锡的IMC,将不深入涉及其他的IMC。
定义
指焊锡与被焊底金属之间,在热量足够的条件下,锡原子和被焊金属原子(如铜、镍)相互结合、渗入、迁移及扩散等动作,会很快在两者之间形成一层类似“锡合金”的化合物,称为金属间化合物 (intermetallic compound,IMC) 。
IMC以锡铜之间形成良性Cu6Sn5和恶性Cu3Sn最常见;必须先生成良性的IMC才会有良好的焊接,但老化后与铜底之间会生成恶性IMC。
常见的IMC
1.IMC形貌
下图为一组IMC观察的典型图片。
.jpg) |
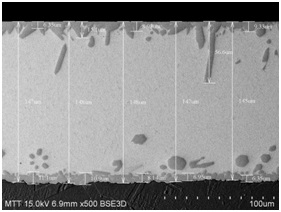 |
 |
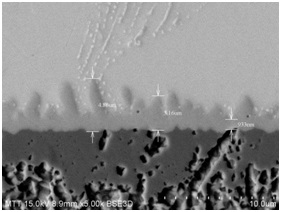 |
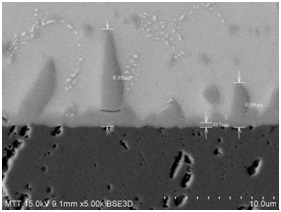 |
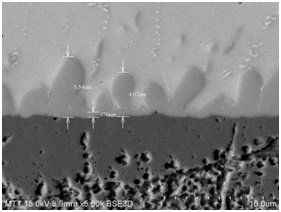 |
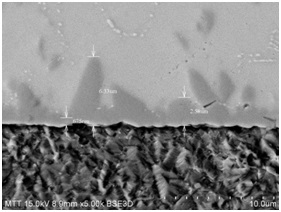 |
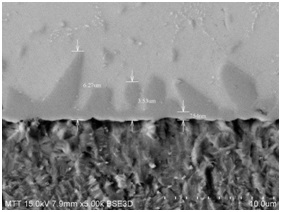 |
| 图1.IMC测试图片 | |
2.IMC的性质
由于IMC曾是一种可以写出分子式的”准化合物”,故其性质与原来的金属已大不相同,对整体焊点强度也有不同程度的影响,首先将其特性简述于下:
IMC在PCB高温焊接或锡铅重熔(即熔锡板或喷锡)时才会发生,有一定的组成及晶体结构,且其生长速度与温度成正比,常温中较慢。一直到出现全铅的阻绝层(Barrier)才会停止。
IMC本身具有不良的脆性,将会损及焊点之机械强度及寿命,其中尤其对抗劳强度(Fatigue Strength)危害最烈,且其熔点也较金属要高。
由于焊锡在介面附近的锡原子会逐渐移走,而与被焊金属组成IMC,使得该处的锡量减少,相对的使得铅量之比例增加,以致使焊点展性增大及固着强度降低,甚至带来整个焊锡体的松弛。
一旦焊垫原有的熔锡层或喷锡层,其与底铜之间已出现”较厚”间距过小的IMC后,对该焊垫以后再续作焊接时会有很大的妨碍;也就是在焊锡性(Solderability)或沾锡性(Wettability)上都将会出现劣化的情形。
焊点中由于锡铜结晶或锡银结晶的渗入,使得该焊锡本身的硬度也随之增加,久之会有脆化的麻烦。
3. IMC对焊接性能的影响
IMC对焊接性能的影响是很复杂的,IMC越厚,焊点在热疲劳测试中越容易失效,其失效模式主要是断裂,裂纹通常发生在焊点内部IMC与焊料形成的界面处,在焊料内部接近IMC边界处,IMC层内部,所形成的金属间化合物的作用主要是形成焊料与基板之间的连接。IMC是脆性的,而焊料是软的,微小厚度的IMC都会形成稳固的连接,较厚的金属间化合物在热循环的作用下会引起界面处的应力集中,导致脆性断裂。
4. 如何适当控制IMC
焊料与焊盘发生反应在界面处形成一定厚度的金属间化合物,表明界面实现了较好的润湿和连接,但是金属间化合物在低温下较脆,裂纹容易在界面处萌生和扩展,因此该界面层是金属体系失效的潜在因素。 因此,如何适当的控制IMC成为急需解决的首要问题。
Au/Ni/Cu三层结构是一种广泛应用在电子封装器件中采用的焊盘结构。 Au层作为Ni表面的保护膜,具有良好的导电性能、润湿性能和防腐蚀性能等。Ni层由于在钎料中溶解速率很慢,可作为Cu层的阻隔层以防止Cu6Sn5,Cu3Sn等IMC的过量形成。
另外,在化学镀Ni工艺中,镀层中含有一定量的P元素。研究发现, 在回流焊过程中,P不会溶入焊料,并且在Ni层与IMC层形成由Ni,P 和Sn富集的高应力层。P的含量对IMC的厚度有一定影响。但镀层中 P含量较高时,形成在Ni层和IMC之间的富P层有效的阻止了Ni参入反应,减少IMC生成几率,从而降低了IMC厚度。
5. 结论
电子封装的无铅化是新一代微电子产品的发展趋势SnAgCu合金是公认的最有可能替代SnPb焊料的无铅焊料。已有的研究表明,SnAgCu焊料合金与Cu基板间在焊接和使用过程中生成并生长的金属间化合物对界面的强度和破坏行为有重要的影响。焊接过程中界面IMC的形成保证了焊料和基板的冶金结合,而使用过程中IMC的过度生长导致了界面的弱化机械强度甚至开裂。
目前,对SnAgCu-Cu界面IMC生长的机理虽然从扩散理论上有一定的认识,但对IMC生长形貌及其对破坏行为的影响还缺乏定量表征的合适参量,对SnAgCu-Cu界面IMC生长动力学的研究才刚刚开始。对上述问题的深入研究一方面有利于在理论上揭示IMC的形成与长大机理,确定表征IMC生长的合适参量,另一方面对预测SnAgCu无铅焊料焊接器件的可靠性有重要意义。金属间化合物(IMC)广泛应用于工业生产,尤其是新材料领域,具有极诱人的应用前景。
6. 参考标准
JYT 010-1996 分析型扫描电子显微镜方法通则
GB/T 16594-2008 微米级长度的扫描电镜测量方法通则
*** 报告结束 ***
作者简介:
- 联系我们
深圳美信总部
热线:400-850-4050
邮箱:marketing@mttlab.com
苏州美信
热线:400-118-1002
邮箱:marketing@mttlab.com
北京美信
热线:400-850-4050
邮箱:marketing@mttlab.com
东莞美信
热线:400-850-4050
邮箱:marketing@mttlab.com
广州美信
热线:400-850-4050
邮箱:marketing@mttlab.com
柳州美信
热线:400-850-4050
邮箱:marketing@mttlab.com
宁波美信
热线:400-850-4050
邮箱:marketing@mttlab.com
西安美信
热线:400-850-4050
邮箱:marketing@mttlab.com


